최대 관심 항목 : Void

Source of void
Void 발견 위치
주로 중간에서 상단 사이, 밑에서 발생해서 위로 빠져나가다 시간부족으로 붙잡힘 (온도 PROFILE중요)
Collapsible ball - 210 ~ 230 도
noncollapsible ball - 302도(90% Pb, 10 Sn) - 발생빈도 낮다.
Void 의 영향
X-ray 검사
laminography 방식은 고가이지만 void 위치 파악이 쉽다.
transmission 방식은 tilting 기능 사용하여 위치 파악 하면됨
X-ray 검사 계측의 주의사항
Voltage Blooming(Phosphor Blooming)
대책, Anti-blooming film 이용
기준 샘플과 비교 측정
Void 의 제거
통상 BGA IC의 Ball 에는 Void 가 거의 없음
Reflow 의 time-temperature profile 최적화
Flux 양,type,특성 최적화
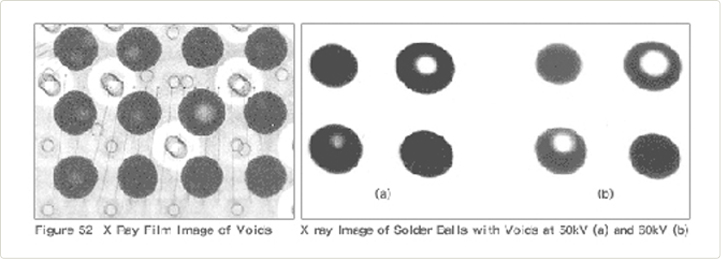

Void 양불 판정 기준
ball size, pitch>작아짐 ; 지속적 불량 증가
| Location of Void | Class Ⅰ | Class Ⅱ | Class Ⅲ |
|---|---|---|---|
| Void in ball (dimple)%Dia. / % area | 60% of dia=36% of area | 45% of dia=20 1/4% of area | 30% of dia=9% of area |
| 50% of dia=25% of area | 35% of dia=12 1/4% of area | 20% of dia=4% of area |
Solder bridge



Opens


Cold solder





불량 과 프로세스 개선





Insufficient/Uneven Heating

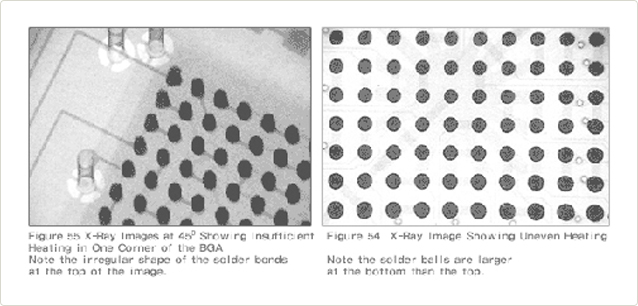
Component Defect