Ball 지름
Insufficient/Nneven Heating
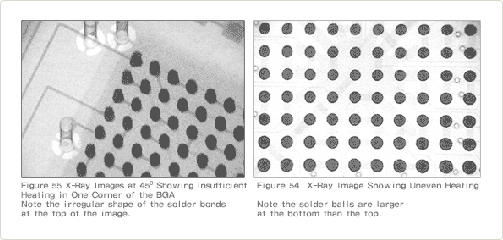
| Profile Topic | Temperature Range | Time Range |
|---|---|---|
| Flux Activation | 100° - 110° C Not to exceed 120° C | N/A |
| Flux Activation | 120° to 150° C | 30 to 120 seconds |
| Component Ramp Rate | 2° to 4° C per second | - |
| Reflow Dwell time | Aboce 183° C | 30 to 90 seconds |
| Solder joint Temp. Reak | 200° to 220° C | - |
| Component Max Temp | 230° C | 60 seconds |
| Board Temperature | Above 150° C | Not to exceed four minutes |
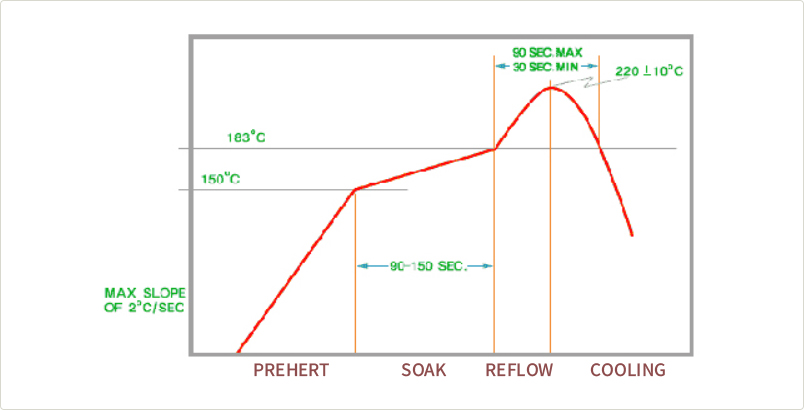
| SOLDERING 불량용어 | 규격용어 | ||
|---|---|---|---|
| Soldering | Solder oint | KS | Korean Standard |
| 쇼트 | Solder Bridging | JIS | Japan Industries Standard |
| 냉납 | Cold Solder | ANS | American National Standard |
| 미납(납부족) | Insufficient Solder/td> | IPC | The Institude For Interconnection And Packaging |
| 납없음 | No Solder | JEDEC | Joint Electronic Device Engineering Council |
| 과납 | Excessive Solder | EIA | Electronic Industires Association |
| 미삽(미 장착) | Non Mounting | MIL | Military Specification And Standard |
| 오삽(오 장착) | Wrong Mounting | ||
| 역삽(역 장착) | Reverse Mounting | ||
| 납크랙 | Solder Crack | ||
| 부품크랙 | Component Crack | ||
| 솔더볼 | Solder Balls | ||
| 젖음불량 | Non-Wetting | ||
| 일어섬 | Tombstoning(Manhattan) | ||
| 틀어짐 | Missing Alignment | ||
| 들뜸 | Bent Lead | ||
| 뒤집힘 | Upside Down | ||
| 이물(오염) | Contamin ated Solder | ||
| 기포/핀홀 | Void / Pin Holes | ||
| 고드름 | Icicles / Protrusions | ||